先进封装持续进化,混合键合技术扮演关键角色
摘要
为了让晶片运算性能沿著摩尔定律持续跃升,利用小晶片设计搭配2.5D、3D先进封装技术,预期会是高阶晶片必然的发展趋势之一;然既有的微凸块接合技术可能会让高阶晶片难以充分发挥效能,必须由混合键合技术取而代之。本篇报告一方面分析小晶片设计与先进封装技术的发展趋势,另一方面则分析混合键合技术对于未来高阶晶片发展的必要性及其发展动态。
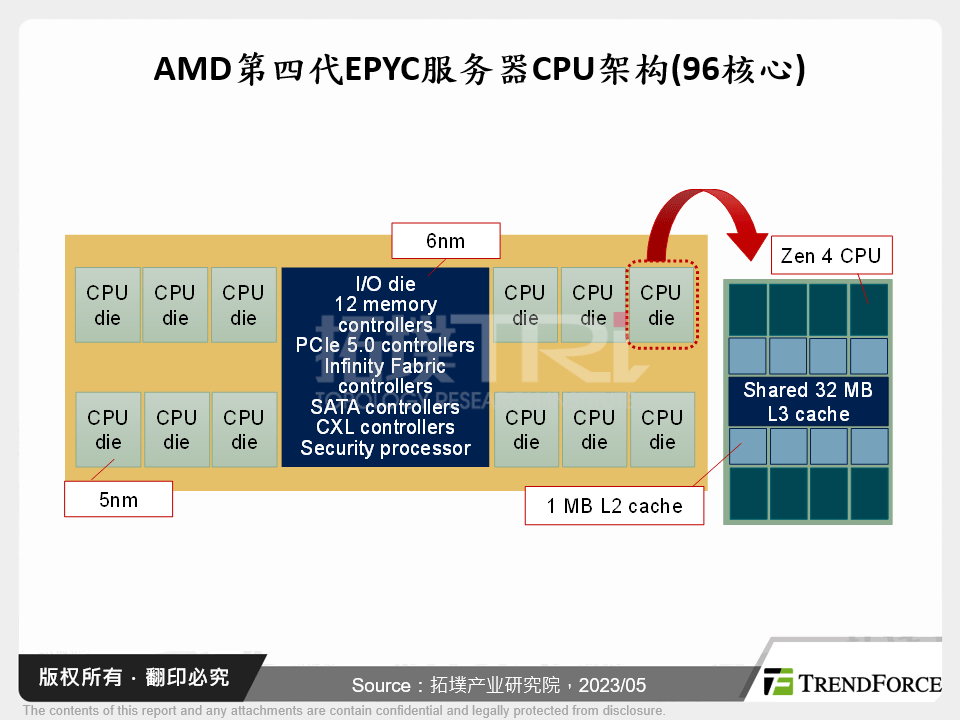
为了让晶片运算性能沿著摩尔定律持续跃升,利用小晶片设计搭配2.5D、3D先进封装技术,预期会是高阶晶片必然的发展趋势之一;然既有的微凸块接合技术可能会让高阶晶片难以充分发挥效能,必须由混合键合技术取而代之。本篇报告一方面分析小晶片设计与先进封装技术的发展趋势,另一方面则分析混合键合技术对于未来高阶晶片发展的必要性及其发展动态。
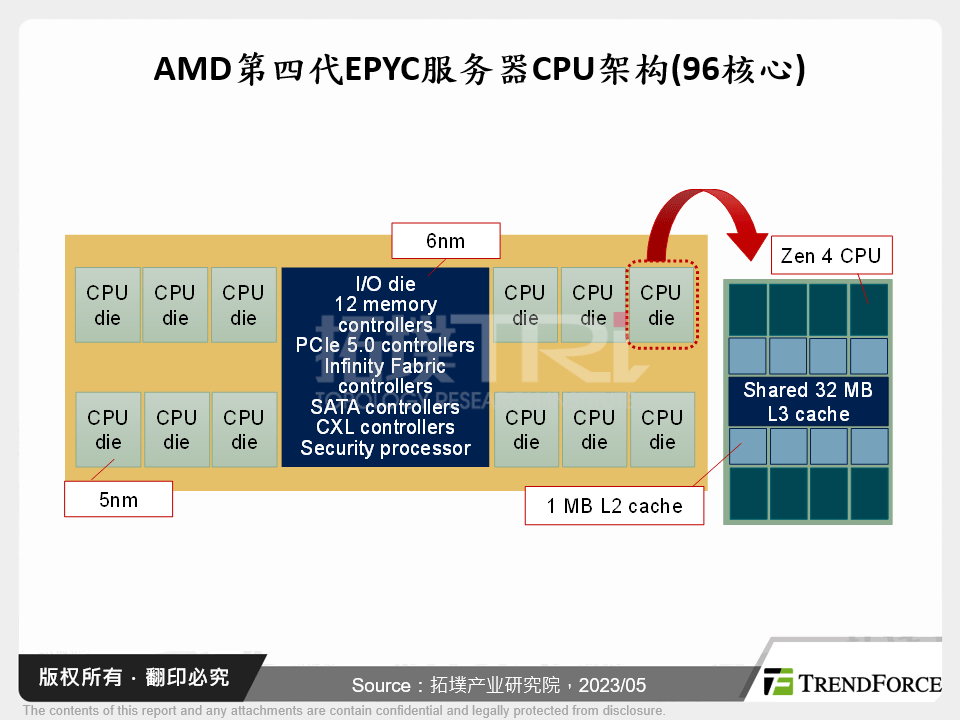
© 2026 拓墣科技 及/或 集邦科技(集邦咨询顾问(深圳)有限公司) 版权所有